Publications
Below is a chronological list of my publications in refereed journals. For recent highlights, please visit my profile at . For citation statistics, see my or profile.
- L. Zhang, Y. Zhang, D. Yang, Y. He, S. Li, Z. Wang, Y. Gong*. Research progress on mechanics computational methods for multi-scale electronic packaging structures (电子封装多尺度结构力学计算方法研究进展) (In Chinese). Chinese Journal of Applied Mechanics (2026) Accepted
- Y. Gong, Y. He, Y. Mei*, X. Zhuang*, F. Qin, T. Rabczuk. Physics-informed Kolmogorov-Arnold networks for multi-material elasticity problems in electronic packaging. Applied Mathematical Modelling 156 (2026) 116793 [arXiv] [Code]

- Y. Gong, S. Li, Y. Mei*,B. Xu, F. Qin, X. Zhuang, T. Rabczuk. A coupled finite element-virtual element method for thermomechanical analysis of electronic packaging structures. Engineering Analysis with Boundary Elements 184 (2026) 106640. [arXiv] [Code]
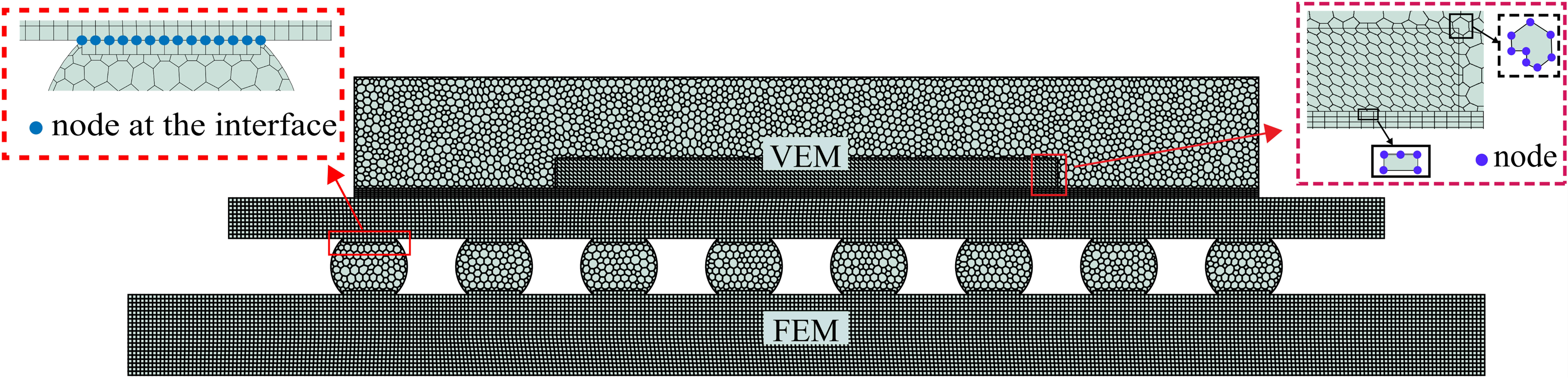
- Y. Gong*, S. Li, F. Qin, B. Xu*. Virtual element method for thermomechanical analysis of electronic packaging structures with multi-scale features. Engineering with Computers 41 (2025) 4799–4824 [arXiv] [Code]

- X. Zhuang*, H. Hu**, S. S. Nanthakumar, Q.-T. Tran, Y. Gong, T. Rabczuk. Variationally consistent Maxwell stress in flexoelectric structures under finite deformation and immersed in free space. Applied Mathematical Modelling (2025) 116327
- Y. Gong*, Y. Kou, Q. Yue*, X. Zhuang*, N. Valizadeh, F. Qin, Q. Wang, T. Rabczuk. A phase-field study on thermo-mechanical coupled damage evolution and failure mechanisms of sintered silver interconnections. Engineering Fracture Mechanics (2025) 111039
- Y. Gong*, Y. He, H. Hu, X. Zhuang*, F. Qin, H. Xu, T. Rabczuk. A coupled finite element–boundary element method for transient elastic dynamic analysis of electronic packaging structures. Engineering Structures 326 (2025) 119500
- H. Liu, F. Wang*, S. Cheng, L. Qiu, Y. Gong. Shape optimization of sound barriers using an isogeometric meshless method. Physics of Fluids 36(2) (2024) 027116
- S. Li, Y. Gong*, F. Qin, P. Chen. Virtual Element Method for Thermomechanical Problems in Electronic Packaging. 2025 26th International Conference on Electronic Packaging Technology (ICEPT) (2025) 1-6
- Y. Gong, Y. Kou, Q. Yue*, X. Zhuang*, F. Qin, Q. Wang, T. Rabczuk. The application of thermomechanically coupled phase-field models in electronic packaging interconnect structures. International Communications in Heat and Mass Transfer 159 (2024) 108033
- Y. He, Y. Gong*, H. Xu, F. Qin. A FEM-BEM Coupling Scheme for Elastic Dynamics Problems in Electronic Packaging. 2024 25th International Conference on Electronic Packaging Technology (ICEPT) (2024) 1-5
- S. Song, T. An*, F. Qin, Y. Gong, Y. Dai, P. Chen. Effect of Different Solder Layer Damage on Junction Temperature of IGBT Module. 2024 25th International Conference on Electronic Packaging Technology (ICEPT) (2024) 1-4
- F. Qin, Q. He, Y. Gong*, C. Hou, H. Cheng, T. An, Y. Dai, P. Chen. An Automatic Finite Element Method-Boundary Element Method Coupling Method for Elastic–Plastic Problems of Multiscale Structures in Electronic Packaging. Journal of Electronic Packaging 145(2) (2023)
- H. Xu, Y. Gong*, Y. Kou, F. Qin. An isogeometric boundary element scheme for transient heat transfer problems in electronic packaging. 2023 24th International Conference on Electronic Packaging Technology (ICEPT) (2023)
- T. An, X. Chen, Q. Wang, J. Han*, F. Qin, Y. Dai, P. Chen, Y. Gong. Effect of Si segregation at grain boundaries on the mechanical behaviours of ageing Al metallization layer in insulated gate bipolar transistor module. Molecular Simulation 49(13-14) (2023) 1281-1292
- Y. Dai*, S. Zhao, F. Qin*, T. An, Y. Gong, P. Chen. Shear fracture resistance enhancement through micropatterning on copper substrate for sintered nano silver joints. International Journal of Adhesion and Adhesives 125 (2023) 103422
- M. Zhang, F. Qin*, S. Chen, Y. Dai*, Y. Jin, P. Chen, T. An, Y. Gong. Holding time effect on mechanical properties and protrusion behaviors of through silicon via copper under various annealing processes. Materials Science in Semiconductor Processing 158 (2023) 107353
- T. An*, R. Zhou, F. Qin*, Y. Dai, Y. Gong, P. Chen. Comparative Study of the Parameter Acquisition Methods for the Cauer Thermal Network Model of an IGBT Module. Electronics 12(7) (2023) 1650
- M. Zhang, F. Qin*, S. Chen, Y. Dai, Y. Jin, P. Chen, T. An, Y. Gong. Effect of Capped Cu Layer on Protrusion Behaviors of Through Silicon via Copper (TSV-Cu) Under Double Annealing Conditions: Comparative Study. IEEE Transactions on Device and Materials Reliability 23(1) (2023) 89-98
- F. Wang*, Z. Chen, Y. Gong*. Local knot method for solving inverse Cauchy problems of Helmholtz equations on complicated two‐ and three‐dimensional domains. International Journal for Numerical Methods in Engineering 123(20) (2022) 4877-4892
- F. Qin, Q. He, Y. Gong*, T. An, P. Chen, Y. Dai. The application of FEM-BEM coupling method for steady 2D heat transfer problems with multi-scale structure. Engineering Analysis with Boundary Elements 137 (2022) 78-90
- Y. Gong*, F. Qin, C. Dong, J. Trevelyan. An isogeometric boundary element method for heat transfer problems of multiscale structures in electronic packaging with arbitrary heat sources. Applied Mathematical Modelling 109 (2022) 161-185
- B. Yu, G. Cao, S. Ren, Y. Gong, C. Dong*. An isogeometric boundary element method for transient heat transfer problems in inhomogeneous materials and the non-iterative inversion of loads. Applied Thermal Engineering 212 (2022) 118600
- F. Qin, S. Zhao, Y. Dai*, Y. Hu, T. An, Y. Gong. Mud-Cracking Effect of Sintered Silver Layer on Quantifying Heat Transfer Behavior of SiC Devices Under Power Cycling: Voronoi Tessellation Model. IEEE Transactions on Components, Packaging and Manufacturing Technology 12(6) (2022) 964-972
- S. Zhao, Y. Dai*, F. Qin, Y. Li, T. An, Y. Gong. Effect of surface finish metallization layer on shearing fracture toughness of sintered silver bonded joints. Engineering Fracture Mechanics 264 (2022) 108355
- L. Chen, H. Lian, Z. Liu, Y. Gong, C. Zheng, S. Bordas*. Bi-material topology optimization for fully coupled structural-acoustic systems with isogeometric FEM–BEM. Engineering Analysis with Boundary Elements 135 (2022) 182-195
- T. An*, Z. Li, Y. Zhang, F. Qin, L. Wang, Z. Lin, X. Tang, Y. Dai, Y. Gong, P. Chen. The Effect of the Surface Roughness Characteristics of the Contact Interface on the Thermal Contact Resistance of the PP-IGBT Module. IEEE Transactions on Power Electronics 37(6) (2022) 7286-7298
- C. Ma, F. Qin, Y. Gong*, C. Hou, H. Cheng, Q. He. A novel coupling simulation scheme for elastoplastic problems of multiscale structures in electronic packaging. 2022 23rd International Conference on Electronic Packaging Technology (ICEPT) (2022) 1-4
- T. An*, Y. Tian, F. Qin, Y. Dai, Y. Gong, P. Chen. Comparison of junction temperature variations of IGBT modules under DC and PWM power cycling test conditions. Journal of Power Electronics 22(9) (2022) 1561-1575
- S. Zhao, S. Chen, F. Qin*, Y. Dai, Y. Gong. Thermal stress analysis of wafer-level multilayer stacking process for 3D-TSV packaging. 2022 23rd International Conference on Electronic Packaging Technology (ICEPT) (2022) 1-4
- R. Zhou, T. An*, F. Qin, Y. Gong, Y. Dai, P. Chen. Influence of chip layout on temperature distribution of multi-chip press pack IGBT devices. 2022 23rd International Conference on Electronic Packaging Technology (ICEPT) (2022) 1-4
- Y. Tian, T. An*, F. Qin, Y. Gong, Y. Dai, Y. Chen. Stress analysis of automotive IGBT module under vibration load. 2022 23rd International Conference on Electronic Packaging Technology (ICEPT) (2022) 1-4
- H. Yu, Y. Guo, Y. Gong*, F. Qin. Thermal analysis of electronic packaging structure using isogeometric boundary element method. Engineering Analysis with Boundary Elements 128 (2021) 195-202
- C. Wang, F. Wang*, Y. Gong*. Analysis of 2D heat conduction in nonlinear functionally graded materials using a local semi-analytical meshless method. AIMS Mathematics 6(11) (2021) 12599-12618
- B. Yu*, G. Cao, Z. Meng, Y. Gong, C. Dong. Three-dimensional transient heat conduction problems in FGMs via IG-DRBEM. Computer Methods in Applied Mechanics and Engineering 384 (2021) 113958
- B. Yu, G. Cao, Y. Gong*, S. Ren, C. Dong. IG-DRBEM of three-dimensional transient heat conduction problems. Engineering Analysis with Boundary Elements 128 (2021) 298-309
- F. Qin, L. Zhang, P. Chen*, T. An, Y. Dai, Y. Gong, Z. Yi, H. Wang. In situ wireless measurement of grinding force in silicon wafer self-rotating grinding process. Mechanical Systems and Signal Processing 154 (2021) 107550
- F. Qin, S. Zhao, L. Liu, Y. Dai*, T. An, P. Chen, Y. Gong. Thickness and metallization layer effect on interfacial and vertical cracking of sintered silver layer: A numerical investigation. Microelectronics Reliability 124 (2021) 114290
- S. Zhao, Y. Dai*, F. Qin**, Y. Li, L. Liu, Z. Zan, T. An, P. Chen, Y. Gong, Y. Wang. On mode II fracture toughness of sintered silver based on end-notch flexure (ENF) test considering various sintering parameters. Materials Science and Engineering: A 823 (2021) 141729
- Y. Gong*, C. Dong, F. Qin, G. Hattori, J. Trevelyan. Hybrid nearly singular integration for three-dimensional isogeometric boundary element analysis of coatings and other thin structures. Computer Methods in Applied Mechanics and Engineering 367 (2020) 113099
- F. Sun, Y. Gong, C. Dong*. A novel fast direct solver for 3D elastic inclusion problems with the isogeometric boundary element method. Journal of Computational and Applied Mathematics 377 (2020) 112904
- Y. Guo, H. Yu, Y. Gong*, F. Qin. Thermal analysis of IGBT by isogeometric boundary element method. 2020 21st International Conference on Electronic Packaging Technology (ICEPT) (2020) 1-5
- F. Qin, Y. Hu, Y. Dai*, T. An, P. Chen, Y. Gong, H. Yu. Crack Effect on the Equivalent Thermal Conductivity of Porously Sintered Silver. Journal of Electronic Materials 49(10) (2020) 5994-6008
- Y. Gong, J. Trevelyan, G. Hattori, C. Dong*. Hybrid nearly singular integration for isogeometric boundary element analysis of coatings and other thin 2D structures. Computer Methods in Applied Mechanics and Engineering 346 (2019) 642-673
- Y. Gong, H. Yang, C. Dong*. A novel interface integral formulation for 3D steady state thermal conduction problem for a medium with non-homogenous inclusions. Computational Mechanics 63(2) (2019) 181-199
- F. Sun, C. Dong*, Y. Wu, Y. Gong. Fast direct isogeometric boundary element method for 3D potential problems based on HODLR matrix. Applied Mathematics and Computation 359 (2019) 17-33
- Y. Gong, C. Dong*, X. Qu. An adaptive isogeometric boundary element method for predicting the effective thermal conductivity of steady state heterogeneity. Advances in Engineering Software 119 (2018) 103-115
- X. Qu, C. Dong*, Y. Bai, Y. Gong. Isogeometric boundary element method for calculating effective property of steady state thermal conduction in 2D heterogeneities with a homogeneous interphase. Journal of Computational and Applied Mathematics 343 (2018) 124-138
- Y. Gong, C. Dong*, X. Qin. An isogeometric boundary element method for three dimensional potential problems. Journal of Computational and Applied Mathematics 313 (2017) 454-468
- Y. Gong, C. Dong*, Y. Bai. Evaluation of nearly singular integrals in isogeometric boundary element method. Engineering Analysis with Boundary Elements 75 (2017) 21-35
- Y. Gong, C. Dong*. An isogeometric boundary element method using adaptive integral method for 3D potential problems. Journal of Computational and Applied Mathematics 319 (2017) 141-158
- X. Qin, C. Dong*, F. Wang, Y. Gong. Free vibration analysis of isogeometric curvilinearly stiffened shells. Thin-Walled Structures 116 (2017) 124-135
- Y. Zhang*, Y. Gong, X. Gao. Calculation of 2D nearly singular integrals over high-order geometry elements using the sinh transformation. Engineering Analysis with Boundary Elements 60 (2015) 144-153
- X. Li, Y. Zhang*, Y. Gong, Y. Su, X. Gao. Use of the sinh transformation for evaluating 2D nearly singular integrals in 3D BEM. Acta Mechanica 226(9) (2015) 2873-2885
- Y. Gong, Z. Jiang*, Y. Gao. On Jacobsthal and Jacobsthal-Lucas Circulant Type Matrices. Abstract and Applied Analysis 2015 (2015) 418293
- C. Ma, Y. Gong*, C. Hou, F. Qin. Analysis of FEM-BEM Coupling Method for Structures in Electronic Packaging (in Chinese). Structure & Environment Engineering 49(5) (2022)
- S. Zhao, Y. Gong*, C. Hou, F. Qin. Application of Direct Multilevel Finite Element Method in Multiscale Package Structures (in Chinese). Structure & Environment Engineering 49(5) (2022)
- G. Sun, Y. Gong*, C. Hou, Y. Li, F. Qin. Multiscale Package Structure Analysis Method Based on RVE-Submodel Method (in Chinese). Structure & Environment Engineering 49(3) (2022)
- C. Dong, Y. Gong, F. Sun. Isogeometric Boundary Element Method (等几何边界元法). Science Press, Beijing, 1st Edition (May 2023) ISBN: 9787030742926